AP/BB、Controller用倒装芯片接合高密度封装基板
并非通过引线焊接与半导体接合,而是通过凸块在翻转的状态下与基板连接,因此被称为 FCCSP(Flip Chip Chip Scale Package)。
主要用于移动 IT 设备的 AP(Application Processor) 等高性能半导体。另外,与使用 Gold Wire的 WBCSP相比,电信号的
移动路径较短,可形成大量的 Input/Output,因此可行对高密度半导体。
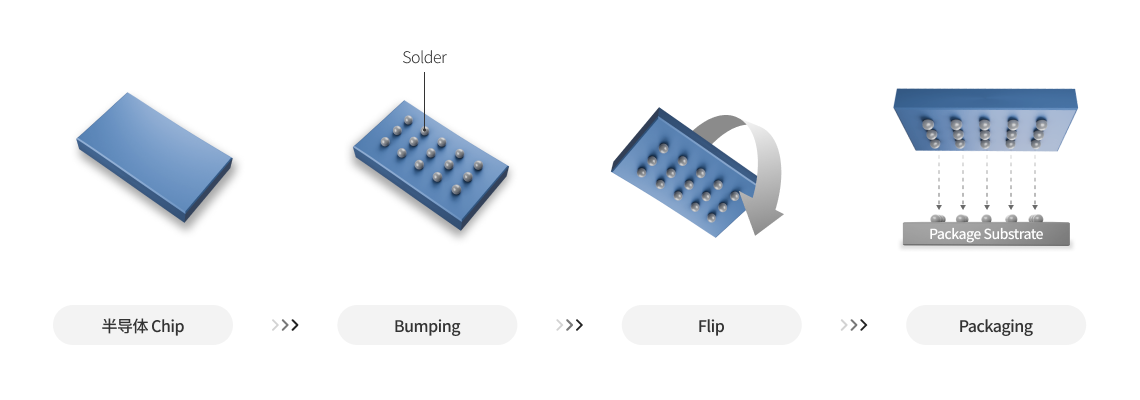
主要核心技术
Bumping 结构图
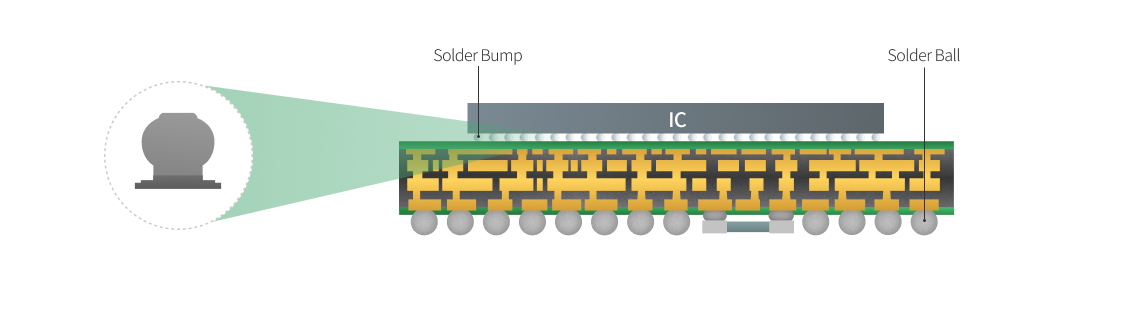
Micro Ball Bump 工艺
- Available for Fine Bump Pitch
- Good for Small Bump Risk
- Good Quality for Bump Characteristics
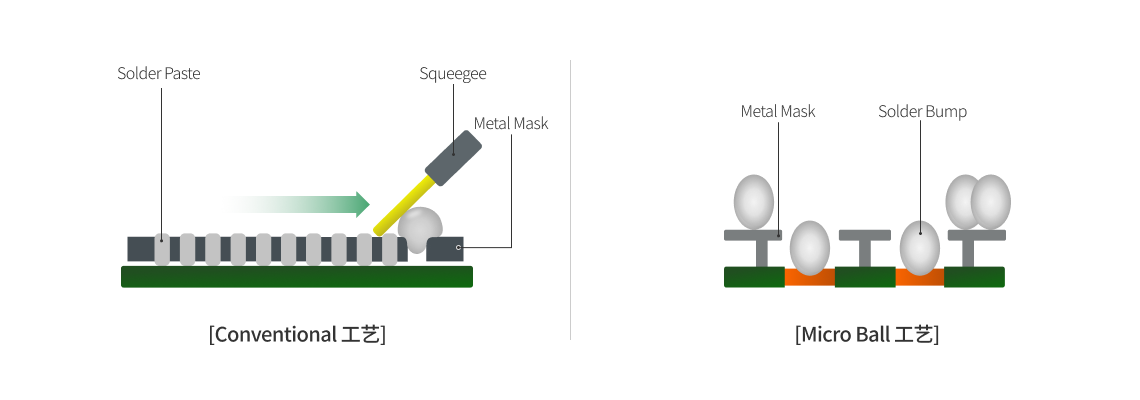
基板种类
EPS & EDS (Embedded Passive Substrate & Embedded Die Substrate)
EPS/EDS是将半导体被动元件、IC 等内置于基板内部的基板。被动元件通常用于稳定 Power Supply Voltage Level。将IC内置于基板内部,
可减小封装大小和厚度。
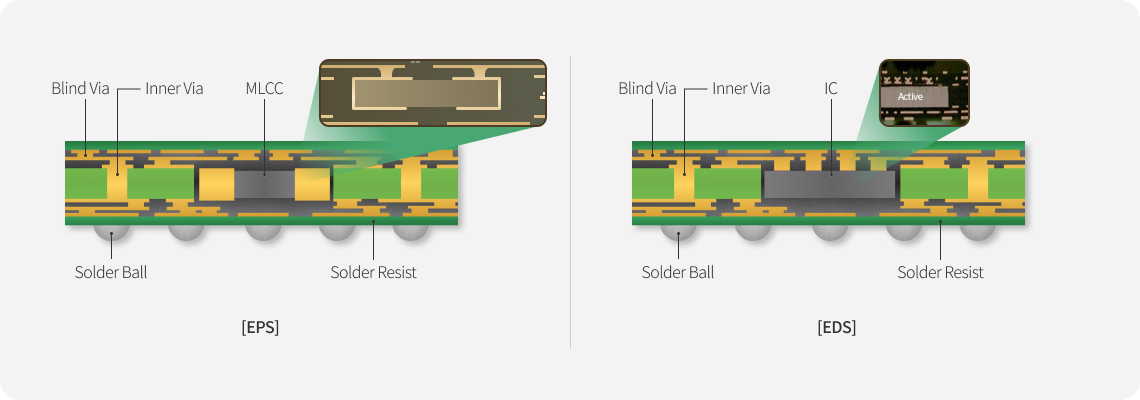
ETS (Embedded Trace Substrate)
ETS是一种将最外层电路Pattern嵌入绝缘材料内部的电路基板。基板采用 Coreless 结构,无需增加 Cost,即可实现微电路,便于层叠设计
(4L → 3L)。另外,由于蚀刻工艺不影响Pattern宽度,因此可以精确地控制电路宽度。

FCCSP Lineup
Lineup by Specification
| Routing Density | Build-Up Line Width / Space | 7 / 8um (Mass Production) | 6 / 7um (Sample Available) |
|---|---|---|---|
| BVH / Pad Registration | 40 / 67um (Mass Production) | 37 / 60um (Sample Available) | |
| SRO Diameter SR Registration | 45 ± 10um (Mass Production) | 40 ± 10um (Sample Available) | |
| FC Bump Pitch (Peripheral) | 40um (Mass Production) | 35um (Sample Available) | |
| FC Bump Pitch (Area) | 90um (Mass Production) | 80um (Sample Available) | |
| Low Z-Height | Core / PPG Thickness | 40 / 18um (Mass Production) | 35 / 15um (Sample Available) |
| SR Thickness | 10 ± 4um (Mass Production) | 8 ± 3um (Sample Available) |
* um是指㎛。